1. Классификация твердых тел по
электрофизическим свойствам. Классическая электронная теория проводимости
2. Основы зонной теории твердого тела.
3. Заполнение энергетических зон
электронами и деление тел на металлы, диэлектрики и полупроводники.
4. Эффективная масса носителей заряда.
5.Собственный
полупроводник. Локальные уровни в запрещенной зоне.
6. Плотность электронных состояний.
7.
Функция распределения Ферми-Дирака
8.
Концентрация эл-ов и дырок в зонах.
9. Концентрация носителей заряда в
невырожденном проводнике.
10. Концентрация носителей заряда в вырожденном полупроводнике
11. Степень заполнения примесных
уровней. Уравнение электронейтральности
12. Температурная зависимость
концентрации плотности заряда в полупроводниках
13. Температурная зависимость
электропроводимости п/п-ов.
14. Квазиуровень Ферми.
15.Время жизни неравновесных носителей
заряда. Межзонная рекомбинация
16.
Фотопроводимость полупроводников. Эффект Дембера
17.Уравнение непрерывности
18.
Диффузионные и дрейфовые токи
19. Диффузия и дрейф неравновесных
носителей заряда в случае в случае монополярной проводимости
20. Диффузия и дрейф неосновных
избыточных носителей заряда
21. Полупроводник во внешнем
электрическом поле
22. Контакт метал-полупроводник.
Омический контакт
23.Выпрямление тока в контакте
метал-полупровадник. Диоды Шотки
24. Емкость запорного слоя Шотки
25. Контакт электронного и дырочного
полупроводников
26. Толщина слоя объемного заряда р-н
перехода
27. Выпрямление тока в р-н переходе
28. ВАХ тонкого р-н перехода
29. Барьерная и диффузионная емкости
p-n-перехода
30. Контакт вырожденных электронного и
дырочного полупроводников
31. Фотоэффект на p-n-переходе
32. Гетеропереходы
33. Принцип действия Б.Т. Физические
параметры Б.Т.
35. Полевые транзисторы с p/n переходом в качастве затвора.
36. Эффект поля. МДП-транзисторы
1. Классификация твердых тел по электрофизическим
свойствам.
Классическая электронная теория проводимости
Электрический ток – направленное движение заряженных
частиц (электронов). Все твердые тела по величине удельной проводимости
разделяются на 3 класса:
![]() - высокопроводящие (металлы)
- высокопроводящие (металлы)
![]() диэлектрики (изоляторы)
диэлектрики (изоляторы)
![]() - полупроводники
- полупроводники
Металлы не всегда можно разделить на металлы и
полупроводники ![]() п/п зависит от примеси. При изучении зависимости
п/п зависит от примеси. При изучении зависимости ![]() удалось разграничить металлы и полупроводники.
удалось разграничить металлы и полупроводники.

![]() - метал
- метал
 - полупроводник
- полупроводник
Но для полупроводников существуют такие интервалы
температур, в которых ![]() падает с ростом Т. Для полупроводников
электропроводность зависит от многих факторов: излучения, давления, Т… Т.о.
разграничили металлы и полупроводники.
падает с ростом Т. Для полупроводников
электропроводность зависит от многих факторов: излучения, давления, Т… Т.о.
разграничили металлы и полупроводники.
Классическая электронная теория
проводимости (1900г)
В ней поведение частиц описывается на основе законов
классической механики. Согласно теории электроны свободны (обобществлены),
кристаллическая решетка состоит из ионов. Один электрон, двигаясь, исп упр
соударения с атомами и другими электронами. Считалось, что электронный газ не
имеет объема электроны не
взаимодействуют друг с другом.
Считалось, что электроны исполняют хаотические тепловое
движение. При внешнем поле Е=0 средняя скорость электронов в выделенном
направлении равна 0, т.е. электронный ток не протекает. Тепловая
скорость движения электронов ~ ![]() см/с. Если к металлу
в котором есть свободные Электроны приложить внешнее эл поле не равное
0, то в противоположном направлении появится преимущественно составляющая
движения электронов.
см/с. Если к металлу
в котором есть свободные Электроны приложить внешнее эл поле не равное
0, то в противоположном направлении появится преимущественно составляющая
движения электронов.
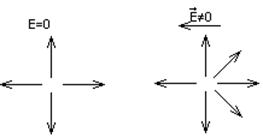
Вводится понятие дрейфовой скорости
![]()
![]() ,
, ![]() - коофициент пропорциональности, подвижности
электронов, дрейфовая подвижность. Физический смысл подвижности:
- коофициент пропорциональности, подвижности
электронов, дрейфовая подвижность. Физический смысл подвижности:


![]() - средняя
- средняя ![]() в единичном эл поле
в единичном эл поле
![]() характеризирует поведение электронов в данном
твердом теле, кот зависит от структуры твердого тела. Посчитаем
характеризирует поведение электронов в данном
твердом теле, кот зависит от структуры твердого тела. Посчитаем ![]()

![]()
S-выделенная площадка в ТТ. Плотность эл. тока  , Q - заряд прошедший через S.
, Q - заряд прошедший через S.
Если концентрация свободных электронов молекуле = n, то 
![]()
Закон Ома в дифференциальном виде ![]()
Предполагалось, что на электрон во внешнем E действует
сила ![]()
![]() - масса электрона в твердом теле
(эффектная масса электрона).
- масса электрона в твердом теле
(эффектная масса электрона).
Масса свободного электрона ![]() .
.
![]() вводится для того, чтобы не учитывать
взаимодействия электрона.
вводится для того, чтобы не учитывать
взаимодействия электрона.

![]()
Вводят понятие длины и времени свободного пробега ![]() .
.
 - средне
арифметическое
- средне
арифметическое ![]() (здесь считали,
что для всех
(здесь считали,
что для всех ![]() явл. постоянным. Реально
явл. постоянным. Реально ![]() распределение по
распределение по ![]() ). Подробное вычисление даёт
). Подробное вычисление даёт 

при рассмотрении с позиций квант. механики были получены
более подробные описания .
2. Основы
зонной теории твердого тела.
На основании квантовой теории эл-н обладает как световыми
частицы, так и свойствами волны. Для электрона вводились волновой вектор,
энерг. уровень. Для атома водорода было решено ур-е Шредингера, в рез. чего
получено, что энерг. уровень эл-на дискретный. Для эл-на введены 4 кв. числа.
Для нас наиболее важным является спиновое

Принцип запрета Паули: на одном энергетическом уровне не
могут находиться 2 эл-на с одинаковым набором КЧ. Чаще атомы являются
связанными в молекулы. За счёт перекрытия эл-ных оболочек атомов (перекрытия
ХФ), происходит расщепление энерг. уровней. На одном уровне ![]() , на втором -
, на втором - ![]() . Объединиться в молекулу водорода атомам водорода
энергетически выгодно.
. Объединиться в молекулу водорода атомам водорода
энергетически выгодно.

Учет взаимодействия
электронов между собой и ядрами приводит к более сложным уравнениям Шредингера.
При рассмотрении кристаллической решётки каждый энергетический уровень
расщепляется на n подуровней, где n - количество атомов в кристаллической
решётке.
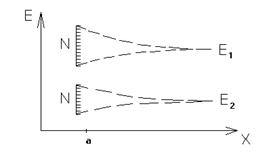
a - постоянная решётки. В твёрд. теле говорят не об
энергетических уровнях уровнях, а о зонах. Внешние электроны атома (с большой
E) - валентные. Между энергетическими зонами может существовать запрещ. энергии
(для перехода между зонами необх. квант. E или излучение кванта E). Но
зоны могут и перекрываться.
Пусть есть N атомов
(ЗЗ-запр. зона)

На каждом энергетическом уровне находится 2 электрона с
разными спинами. В процессе эл-проводимости не принимают
электроны, находящихся на низких энергетических уровнях, а только валентные, в
обычном атоме выше запретной зоны находится еще одна доступная зона - зона
проводимости.

Если![]() - то матер-л диэлектрик
- то матер-л диэлектрик
если ![]() - полупроводник
- полупроводник
Например:
Si : ![]()
Ge :![]()
В п/п тепловой энергии достаточно для перехода в ЗП.
Для металлов (щелочных)

ВЗ заполнена э-ми
наполовину вслед. з-та Паули. Остальные эл-ны могут уч-ть в процессе эл-ми. При
приложении эл. поля эл-ны получают доп. E.
Для 2-валентных электронов металлов ВЗ зап-на вся.
3.Заполнение энергетических зон
электронами и деление тел на металлы, диэлектрики и полупроводники.
Зонная теория твердых тел позволила с единой точки зрения истолковать существование
металлов, диэлектриков и полупроводников, объясняя различие в их электрических
свойствах, во-первых, неодинаковым заполнением электронами разрешенных зон и,
во-вторых, шириной запрещенных зон. Если ширина запрещенной зоны кристалла
порядка нескольких электрон-вольт, то тепловое движение не может перебросить
электроны из валентной зоны в зону проводимости и кристалл является
диэлектриком, оставаясь им при всех реальных температурах (рис. 314, в). Если
запрещенная зона достаточно узка (DE порядка 1
эВ), то переброс электронов из валентной зоны в зону проводимости может быть
осуществлен сравнительно легко либо путем теплового возбуждения, либо за счет
внешнего источника, способного передать электронам энергию DE, и кристалл является полупроводником (рис. 314, г). Различие между
металлами и диэлектриками с точки зрения зонной теории состоит в том, что при
0 К в зоне проводимости металлов имеются электроны, а в зоне проводимости
диэлектриков они отсутствуют. Различие же между диэлектриками и
полупроводниками определяется шириной запрещенных зон: для диэлектриков она
довольно широка (например, для NaCl DE=6 эВ), для полупроводников— достаточно узка (например, для германия DE=0,72 эВ). При температурах, близких к О К,
полупроводники ведут себя как диэлектрики, так как переброса электронов в зону
проводимости не происходит. С повышением температуры у полупроводников
растет число электронов, которые вследствие теплового возбуждения переходят в
зону проводимости, т. е. электрическая проводимость проводников в этом случае увеличивается.
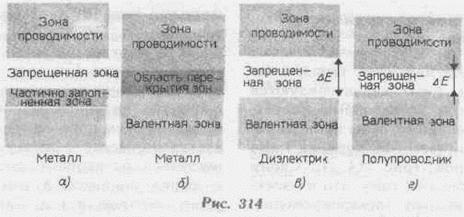
4. Эффективная
масса носителей заряда.
Эл-н двигаясь по твердое тело под действием эл. поля испытывают взаимодействие с другими эл-нами и
ионами. Считаем, что эл-н обладает и волновыми свойствами, и свойствами
частицы. Эл. поле создают силу, которая дает эл-ну ускорение: ![]() ;
; ![]() .
.
Для эл-на в твердое тело важна не мгновенная скорость, а
средняя: ![]()
Пусть ![]() (пост-я
решетки), получим , что
(пост-я
решетки), получим , что ![]() (эл-н находится везде). Для эл-на поэтому вводим
среднюю групповую скорость движения:
(эл-н находится везде). Для эл-на поэтому вводим
среднюю групповую скорость движения: ![]() ,
, ![]() - частота волны,
- частота волны, ![]() - волновой вектор,
- волновой вектор, ![]() .
.
![]() - скорость передвижения максимума
ВФ:
- скорость передвижения максимума
ВФ:
![]()
Ускорение из классической ф-лы:
![]() Работа электрона:
Работа электрона:
![]() ;
; 
 (Считаем,
что F зависит только от поля)
(Считаем,
что F зависит только от поля)
Сравнивая с клас. формулой, находим выраж-ие для массы

 -эффективная масса
-эффективная масса
=m*
![]() m*
не является мерой инертности частицы и не связана с гравит. силами, а явл-ся
лишь коэф-ом проп. между F и а .
m*
не является мерой инертности частицы и не связана с гравит. силами, а явл-ся
лишь коэф-ом проп. между F и а .
Вторая производная ~кривизне зав-ти Е(k)-периодическая
функция.
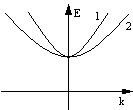 m2* > m1*
m2* > m1*
Масса может менятся в
зависимости от
кривизны. Чем больше Е, тем больше
m* .
Для кубического кр-ла

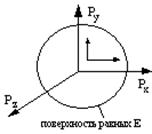
Для некуб. кр-ла пов-ть равных Е – элллипс. Тогда
my*
> mx* .
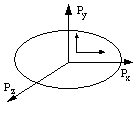 Для свободного электрона
Для свободного электрона



;
Если электрон свободный , то m0 = m* .
 .
.
Рассмотрим
поведение электрона в зоне
проводимости и в валентной зоне

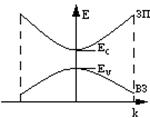
Т. к. m*<0 не имеет смысла, то считают, что
электорн становится дыркой с положительной массой и полож. зарядом.
![]() ,
,
![]()
.
Для дырки mp* > 0,
e > 0.
Совокупность электронов,
дв-ся по вол-ой зоне, создают эффект дв-я полож-го заряда. Проводимость
Будем делить на эл-ю и дырочную.
5. Собственный полупроводник и примесная проводимость.
Собств. п/п –
хим-ки чистый материал, в котором концентрация электронов = концентрации дырок.
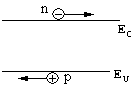
др. энергетических
уровней нет.
n – конц-я электронов в ЗП.
р – конц-я дырок в ВЗ.
![]()
С увел-ем Т большее кол-во эл-ов переходит из Еv
в Ec. Этот процесс наз-ся генерацией. Обратный процесс –
регенерация. Наступает т/д равновесие, n = p.
Для собств. п/п:
![]()
![]()
При n = p = ni (i – собств.) .
В реальных матер-ах сущ-ют примеси, и зонная диаграма
будет иметь другой вид. Дефекты кристаллической решетки могут играть роль
примеси. Для получения эл-го типа проводимости в п/п вводят донорные примеси.
Например, в крист. реш-ку Si (iv – вал.) вводят dS (v вал.).
 Еd – локальный ЭУ при донорной примеси. При
увелич. Т электроны переходят из Еd в Ес .
Еd – локальный ЭУ при донорной примеси. При
увелич. Т электроны переходят из Еd в Ес .
![]() Ес - Еd = ΔЕd <<Еg
Ес - Еd = ΔЕd <<Еg
энергия
ионизации
![]()
![]()
Такой п/п имеет n-тип. Эл-ны – основные носители заряда,
дырки – неосновные. Если ввести в Si аS , то получим п/п р-типа. В п/п будет
акцепторная примесь.
 Вероятность перехода на близ
лежащий уровень > чем на дальний р >> n .
Вероятность перехода на близ
лежащий уровень > чем на дальний р >> n .
![]()
![]()
Осн-ые носители – дырки, эл-ны – неосновные (эл-ны
локализованы в примеси и практически не движ-ся). В п/п может содержатся и
донорная и акцепторная примеси одновременно. Такой п/п будет
наз-ся скомпенсированным при р = n .
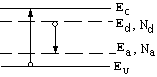 При
нагревании будет возникать большее кол-во эл-ов и дырок, концентрация которых
будет одинакова.
При
нагревании будет возникать большее кол-во эл-ов и дырок, концентрация которых
будет одинакова.
6. Плотность электронных состояний.
Эл-ны в ТТ
подчиняются законам статистики (квантовой).
![]() Плотность
электронных состояний в ЗП:
Плотность
электронных состояний в ЗП:
Z – кол-во энерг-их состояний.
 Для п ростоты возьмем кубический кристалл
Для п ростоты возьмем кубический кристалл
![]() -
приращение
-
приращение
объема в пр-ве имп-ов.
Принцип неопределённости
Гейзенберга:
![]()
![]()
Δk=1
Примем
ΔV=ΔxΔyΔz=1, то 1 электрон в пр-ве имп-ов может занять
объем ![]() (минимум).
(минимум).

,
2 появилась вследствие того, что на
одном ЭУ
может нах-ся 2 эл-на с противополож. спинами.

![]()
![]()
![]()
![]()
![]()
Видим, что N(E) ~ √¯E.
Аналогично можем получить пл-ть эл. состояний для вал. зоны.
![]()
(для эл-ов энергия отсчитывается
вверх от Ec , для дырок - вниз от Ev ).
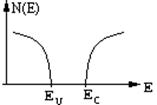
mp* как правило > mn*.
Для
несимметричных кристаллов ф-лы будут подобны(например вместо сферы расм-ся
эллипсоид. Электроны как квантовые
частицы подчиняются ст-ке Ферми-Дирака.
7. Функция Ферми-Дирака
Она описывает пов-е эл-ов в ТТ, Вероятнасть того, что
эл-он обл. данной Е при данной Т
 .
.
![]() F- уровень
Ферми. Будем считать, что T = 0, f
зависит от интервала Е.
F- уровень
Ферми. Будем считать, что T = 0, f
зависит от интервала Е.
![]()
Все ЭУ при 0 К ниже ур.Ферми
зап-ны.
Все ЭУ при 0 К выше ур.Ферми
своб.
Ур. Ферми – Это максимальная энергия эл-ов в металле
в температуре абс. 0 (в п/п ур. Ферми
попадает в запр. зону).
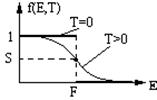
При Т>0 за счет терм-го
возб-я эл-н будет приобретать доп. Е и он будет повышать свой ЭУ. Происходит
«разлиные» ф-ции Ферми-Дирака.
Ур. Фери – это ЭУ, вер-ть заполнения которого = 0.5
при Т ≠ 0 (опр-е и для металлов и для п/п).
Можно убедится, что на границах диап-на энергий. F
= ± kT вер-ты будут соотв. 0,97 и 0,03. kT = 0,025 эВ.
Это ф-ия Ф-Д для эл-ов fn. Аналогичная
ф-ия для дырок строится на основании статистики дырок.

![]()
![]() (Вер-ть того, что на
уровне есть эл-ны = 1 – вер-ть того, что на нём есть дырка.)
(Вер-ть того, что на
уровне есть эл-ны = 1 – вер-ть того, что на нём есть дырка.)

если ехр >> 1, то можем пренебречь 1.

Получили распределение Максвелла-Больцмана ч-ц по
энергии. При ехр >> 1 говорят, что электронный газ в п/п
невырожденный. Иначе –вырожденный (это вом-но, если F
близок к Ec или Еv). Для вырожденных п/п зав-ть n(T) подобна металлам
(не меняется), а для п/п она меняется ехр-но с Т.
8. Концентрация эл-ов и дырок в зонах.
Концентрация эл-ов в ЗП:

(Верхний предел можем выбрать ∞-ым
т.к. функция Ферми-Дирака быстро спадает).
 Приведенный ур. Ферми
Приведенный ур. Ферми
Приведённая энергия

Интеграл Ферми:

Вводят новую переменную так,
чтобы
![]()
Nc – Эффективная плотность состояний в ЗП

Аналогичные рассуждения и для
дырок:
![]()
Пользуются приближениями ![]() (невырожденный
полупроводник) и
(невырожденный
полупроводник) и ![]() (вырожденный).
(вырожденный).
9. Концентрация носителей заряда в невырожденном
проводнике.
Невырожденные – озн., что n зависит
от Т, если не зависит – вырожденные. Для невыр. уровень Ферми находится в
запрещенной зоне. Для невыр. полупроводников:
![]()

 (табличный интеграл)
(табличный интеграл)
![]()
Нас интересует зависимость n(T) (F также
зависит от T).
Для дырок в валентной зоне

Nv – эф. плотность сост. в ВЗ, Ev – потолок ВЗ.



n/Nc всегда < 1, следовательно
ln<0. Чем выше n, тем ближе F будет к
дну ЗП Ec. Аналогично для дырок

F находится выше Ev, причем, чем выше p, тем
ближе F к потолку Ev. В зависимости от того, к какому уровню ближе F, Ec или Ev, соотношения между n и p будут разными.
Если n=p, то (т.е. для собственного
полупроводника)

![]()
![]()

 –
середина запрещенной зоны. При T=0 в собственном
полупроводнике F находится в середине запрещенной зоны.
–
середина запрещенной зоны. При T=0 в собственном
полупроводнике F находится в середине запрещенной зоны.


При ![]() положение F не
зависит от T. Но, как правило,
положение F не
зависит от T. Но, как правило, ![]() , следовательно F поднимается с ростом T.
, следовательно F поднимается с ростом T.
Если считать, что n=p=ni, то получим:
![]()
![]()
В любом полупроводнике:
![]() (соотношение Эйнштейна)
(соотношение Эйнштейна)
![]()
Концентрация носителей заряда
в собственном полупроводнике:

![]()
Собственный полупроводник (n=p=ni)



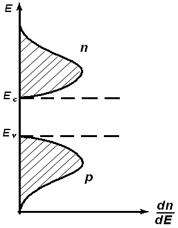
Площадь заштрихованной
области соответствует n или p.
Для полупроводника n-типа:

В полупроводнике n-типа:
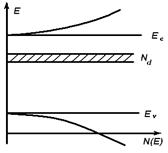
Nd – концентрация атомов донорной примеси (кот. даёт 1 электрон)
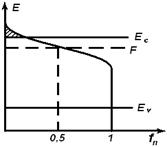
n<<p, но ![]()
В полупроводнике n-типа n>>p
Для металлов все уровни, ниже
F, заполнены, а все, которые выше – свободны.
Для полупроводника р-типа:
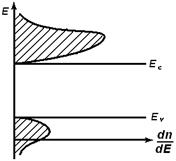

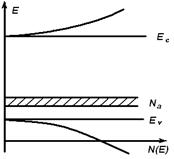

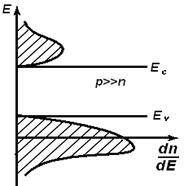
10. Концентрация носителей заряда в вырожденном полупроводнике
Он реализуется в металлах (n≠n(T)) и в
полупроводниках при большой концентрации примеси и в определенном диапазоне Т.
Для сильного вырождения ![]() .
.
Уровень Ферми находится в
разр. зоне в ЗП (для выр. полупроводника n-типа) и в ВЗ ( для выр.
полупроводника р-типа). Это свойство используется в туннельных диодах.

n не зав. от Т

Верхний предел – макс. Е
электронов в ЗП.
 (в металле)
(в металле)

Аналогично для металлов

Разность F-Ec характеризует степень вырождения полупроводника.

 (условие вырождения)
(условие вырождения)
Степень вырождения зависит от
n, T и mn*. С понижением Т при опр.
соотн. n и mn* получим η>>1.
Того же результата можно достичь при данных mn* и Т увеличением n.
11. Степень заполнения примесных уровней. Уравнение
электронейтральности
Рассмотрим полупроводник n-типа.

Концентрация атомов донорной
примеси = Nd. Количество электронных состояний ДП равно
количеству атомов ДП.
![]() – концентрация электронов на уровне ДП.
– концентрация электронов на уровне ДП.

![]() – концентрация дырок на уровнеДП.
– концентрация дырок на уровнеДП.

![]()
Электроны на ЭУ могут
располагаться либо со спином вверх, либо со спином вниз (электрон
характеризуется 4-мя квантовыми числами: главное, орбитальное, магнитное,
спиновое). Заполнение электронами поэтому вдвое больше, чем заполнение дырками.
Вводят стат. коэф-т g (стат. вес электронов в два раза больше стат. веса
дырок)
![]() .
.


![]() -
вероятность зап-я Эл. Ми ЭУ Еg при данной т. аналогично для
дырок.
-
вероятность зап-я Эл. Ми ЭУ Еg при данной т. аналогично для
дырок.



Аналогичная формула
существует для акцепторной примеси:
![]()
Уравнение электронейтральности
УЭН для n/n показ-ет, что количество
плож. зарядов = к-ву отр. зарядов, n/n-к в целом является
электронейтральным. Пусть n/n – к дон. и акц. Примеси.
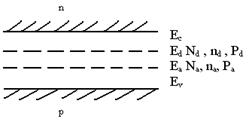
В ны nd и pa не будем учитывать n, k эти величины не несут
электрического заряда
n+na=p+pd – у-е электронейтральности

![]() -
у-е ЭМ в общ. Виде.
-
у-е ЭМ в общ. Виде.
Для п/п-ка n-типа
![]()
Для п\п-ка р-типа:
![]()
12. Температурная зависимость концентрации плотности
заряда в полупроводниках
Будем рассм. п/п-к к-типа
![]()
Nc- эф-я плотность сост-ий в ЗП, Ec. Эта ф-ла частично описывает
зав-ть n(T), но и F тоже
зависит от Т. Для нахождения F(T) воспользуемся у-м ЭН для
п/п –ка типа



Возможны переходы электронов
![]()
При низких Т пренебрегаем 2
слагаемых слева


Необходимо найти F.
Обозначим exp(F\kT)=x


Поскольку exp>0,
то корень х2 отбрасываем



При самых низких Т (около
абс. нуля)


При Т=0
![]()

Концентрация электронов в области активизации примеси:

Нашли n(T) в обл.
низких Т ( в области активации примеси ∆Ed=Ec-Ed –глубина значения данной
примеси
 -
энергия активации темпе-й зависимости n в обл.
низких Т.
-
энергия активации темпе-й зависимости n в обл.
низких Т.
С ростом Т в (*) стан местрад
 -
растет с Т.
-
растет с Т.
В след. Обл. Т (обл.
истощения примеси)
![]() -
но Т все еще низка
-
но Т все еще низка


Концентрация эл-ов в области истощения примеси:

n не зависит от Ти равна
концентрации атомов донарной примеси. (вся примесь активирована).
Температура истощения примеси
Ts находится из условия:


Чем меньше ∆Ed и Nd тем меньше Ts. Например для Ge при Nd = 1016 см -3, ∆Ed = 0.01 эВ =>
Ts = 32 K.
Все п/п приборы работают в этой области Т.
Аналогичные размышления м.б.
получены и для дырок.
3-я область Т – комнатная и
выше – область соответствует проводимости.
n - p = Pd n = p
Переходим к собственной проводимости

 - уравнение Фурье для соб. n/n.
- уравнение Фурье для соб. n/n.
 => с ростом Т F медленно растет.
=> с ростом Т F медленно растет.
Первая точка - T=0.
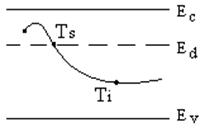
температура начала
собственной проводимости в п/п-ке.
Тi поучим из условия равенства
Ур. Ферми для


![]() зависит от mn*, mp*.
зависит от mn*, mp*.
Концентрация эл. пров. е зависит от Т.
Концентрация электронов в области активизации примеси:

Энергия активации ![]()
В полулогарифмических
координатах кривые n(T) спрямляются.

По tg α
можно о ценить глубину залегания донорной примеси, а tg α - ширину запрещенной
зоны.
Перейдем к Т-ой зависимости
электропроводимости полупроводников.
13.Температурная зависимость электропроводимости
п/п-ов.
![]()
Найдём зависимость ![]()

В области низких Т ![]()
Рассеяния эл-ов восновном
припадает на примеси
При высоких Т ![]() за счёт
столкновений.
за счёт
столкновений.
Вероятность рассеяния эл-ов.

Дял ср. Т.

![]() - в обл. НТ,
- в обл. НТ, ![]() - в обл. ВТ
- в обл. ВТ

В обл Низких Т (обл. активации примеси):

exp –ная зависимость сильнее, чем зав от Т9/4
и поэтому преобладает.
В обл Средних Т:
n = Nd
![]() (слабо зависит от Т, зависит от того какое
слагаемое преобладает)
(слабо зависит от Т, зависит от того какое
слагаемое преобладает)
В области Высоких Т (собственной проводимости).

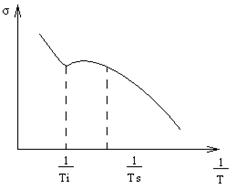
Полупроводниковые приборы
работают в диапазоне Т, в кот. концентрация носителей не зависит от Т.
14. Квазиуровень Ферми.
В п\п-ке происходит генерация
носителей заряда вследствие теплового возмущения. Электроны переходят в зону
проводимости (ЗП), дырки в валентную зону (ВЗ). Параллельно идет рекомбинация
(возвращение электронов в ВЗ, а дырок в ЗП). При равновесии число электронов в
ЗП и число дырок в ВЗ постоянны. Генерация происходит за счет другого вида
возбуждений (светового и…). В этом случае равновесие будет не равновесным. При
этом равновесие энергии сохраняется, а коммутация – отличается. Вводим понятие
квази-уровня Ферми: ![]() , где
, где ![]() - коммутация избыточных (неравновесных) электронов,
- коммутация избыточных (неравновесных) электронов, ![]() - равновесное количество электронов.
- равновесное количество электронов.
![]()
Будем считать, что электроны
и дырки описываются теми же распределениями, что и равновесия электронов и
дырок.
 ,
но уровень Ферми другой.
,
но уровень Ферми другой. ![]() - квази-уровень Ферми для электронов.
- квази-уровень Ферми для электронов.

В п/п-ке с неравновесными
электронами при возрастании n то уровень Ферми
приближается в ЗП, а при понижении р то уровень Ферми приближается к ВЗ. Так
как F-один, то вводим квази-уровни Ферми.
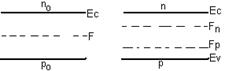
Fn – квази-уровни для электронов, а Fp – для
дырок.


Промежуток ![]() характеризует отклонение от равновесия. Неравновесные
состояния возникают из-за инжекции заряда.
характеризует отклонение от равновесия. Неравновесные
состояния возникают из-за инжекции заряда.
15.Время жизни неравновесных носителей заряда.
Межзонная рекомбинация
Они существуют пока
существует источник возбуждения. После выключения источника, п/п-к в течении
какого-то времени возвращается в
равновесное состояние. Будем
считать, что происходит оптическая генерация.
![]()
При выключении источника
облучения:
![]()
![]() -
скорость генерации в условии равновесия;
-
скорость генерации в условии равновесия;
R – скорость рекомбинации.
![]()
![]() -
коэффициент пропорциональности – коэффициент рекомбинации. Чем больше n0 и p0, тем быстрее происходит
рекомбинация и генерация.
-
коэффициент пропорциональности – коэффициент рекомбинации. Чем больше n0 и p0, тем быстрее происходит
рекомбинация и генерация.
 Считаем,
что
Считаем,
что ![]()

Рассмотрим случаи:
1. ![]()


При t=0 ,![]()
![]() -
установилась при работающем источнике возбуждения.
-
установилась при работающем источнике возбуждения.
![]()
![]()
Это линейная рекомбинация (![]() ).
).
 – постоянная времени рекомбинации (время жизни
неравновесных носителей заряда в п/п-ке)
– постоянная времени рекомбинации (время жизни
неравновесных носителей заряда в п/п-ке)
![]()

Искомое уравнение: 
При линейной рекомбинации ![]()
2. Случай сильного
возбуждения.
![]()

Такой тип рекомбинации
называю квадратичной.


![]() убывает
с t по гиперболическому закону.
убывает
с t по гиперболическому закону.
Постоянная времени ![]() - мгновенное
время жизни неравновесных электронов при квадратичной рекомбинации.
- мгновенное
время жизни неравновесных электронов при квадратичной рекомбинации. ![]() не является постоянным.
не является постоянным.
Межзонная рекомбинация
Существует 2 вида
рекомбинации:
I.
межзонная – электрон из ЗП возвращается в ВЗ с выделением избыточной
энергии
1.
если эта энергия преобразовывается в излучение – это излучательная
рекомбинация (светодиод)
2.
если эта энергия превращается в
тепло – безизлучательная рекомбинация.
3.
если она отдается другим носителям заряда – это уже рекомбинация.
II.
Электрон в ВЗ пролетит через промежуточный уровень-ловушку, которая на
некоторое время задержит его.
Скорость рекомбинации:

Рассмотрим биполярную линейную
рекомбинацию:
![]() ;
;
![]()
Видим, что ![]() - скорость рекомбинации в состоянии равновесия.
- скорость рекомбинации в состоянии равновесия.
![]() -
скорость рекомбинации в неравновесном состоянии (коэффициент рекомбинации).
-
скорость рекомбинации в неравновесном состоянии (коэффициент рекомбинации).

Для собственного п/п-ка ![]()

![]() тем
меньше, чем меньше расстояние запрещенной зоны Eg и чем больше Т.
тем
меньше, чем меньше расстояние запрещенной зоны Eg и чем больше Т.
Для п/п-ка n-типа n0>>p0. Тогда 
Отношение ![]() определяется
степенью легирования п/п-ка. Для п/п-ка р – типа:
определяется
степенью легирования п/п-ка. Для п/п-ка р – типа:

16. Фотопроводимость полупроводников. Эффект Дембера
Рассмотрим зонную
энергетическую диаграмму п/п при облучении его светом (т.е. при генерации)

1- Проводимость растет (это
собственная полупроводимость)
2,3- примесная
фотопроводимость при этом:

В
общем случае электропроводимость

Рассмотрим
от чего будет зависеть ∆n
Из уравнения непрерывности

Фототок (по закону Ома)
 При
τ/t >1 ток становится больше ,иначе- меньше.
При
τ/t >1 ток становится больше ,иначе- меньше.
Явление фотопроводимости
используется в фоторезисторах – это пластина п/п с определенной Ед ,чтобы
быть чувствительным к определенным
длинам волн. В нем
используется собств. полупроводимость
Эффект Дембера
Он возникает в п.п при
облучении его светом с ![]()
В п.п. происходит генерация
эл.-дыр. пар. Они диф-ют в неосвещенных областях полупроводника ![]()
Возникает разделение зарядов.
Возникает эл. поле ![]() которое замедляет движение электронов и ускоряет
дырки.
которое замедляет движение электронов и ускоряет
дырки.
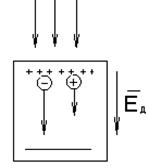
В равновесии (I=0)
между гранями п.п возникает напряжение 
Считаем ,что происходит
биполярная генерация т.е. ∆n=∆p

Из выражения видно, что при b
=1 эффект Дембера не возникает (ЕД=0). Найдем разность потенциалов

Считается, что на расстоянии
3L процесс диффузии уже прекращается (L-диффузионная длина

![]()
На глубине 3L
считаем, что все диф-ие заряды релаксировали.
Контактные явления в
полупроводниках
Эти явления лежат в основе
работы многих п/п приборах: диодах Шотки…
17. Уравнение непрерывности
Это уравнение описывает
процесс изменения концентрации носителей заряда в зависимости от различных
факторов. Рассмотрим неравномерное распределение концентрации электронов вдоль
оси x в зависимости от времени t: n(x,t). Изменение количества
носителей в некотором объеме dx за время dt будет:

генерация линейная рекомб-я изменение
потока эл-ов вдоль коодин-ты.

![]() - уравнение непрерывности для электронов.
- уравнение непрерывности для электронов.
Введем плотность электрического тока электронов:
![]()
![]()
В закономерном случае можно заменить ![]() на
на ![]() . Уравнение непрерывности можно записать и для дырок,
введя плотность электрического тока дырок:
. Уравнение непрерывности можно записать и для дырок,
введя плотность электрического тока дырок:
![]()
![]()
В стационарном случае ![]()
Ток возникает по таким причинам:
1.
Движение электронов во внешнем электрическом поле – дрейфовый ток.;
2.
Разность концентраций электронов – диффузионный ток;
18. Дрейфовые и диффузионные токи
Ток
электронов:![]()
Ток
дырок: ![]()
Dp и Dn – коэффициенты диффузии
электронов и дырок соответственно. Ток направлен туда, где концентрация
носителей меньше.
Плотность
тока электронов:

Аналогично
плотность тока дырок:

В
общем случае плотность тока:
 Выведем
связь D и μ (для электронов).
Выведем
связь D и μ (для электронов).
Будем
считать, что в полупроводнике за счет разделения зарядов (т.е вследствие ![]() ) возникло поле Ест. В равновесии плотность
тока через п/про-к
) возникло поле Ест. В равновесии плотность
тока через п/про-к ![]() .
.

Для
электронов находящихся в стационарном электрическом поле:
![]() ,
где φ – потенциал.
,
где φ – потенциал.
![]()

19. Диффузия и дрейф неравновесных носителей заряда в
случае в случае монополярной проводимости
Диффузия и дрейф основных
неравновесных носителей заряда
Рассмотрим пластину пп на
которую падает свет.

Будем считать что освещение
приводит к образованию новых электронов , но не дырок. ∆n – изб.
концентр. электронов. В направлении оси х существует градиент конц. электронов,
как следствие возникает диффузионное движение электронов, происходит разделение
зарядов => возникает внутреннее эл. поле => дрейфовое движение
электронов, этот дрейфовый ток уравновешивая диффузионный и суммарный ток
станет равным нулю

(использовали формулу (*))
Уравнение Пуассона

Рассмотрим случай слабого
возбуждения т.е.![]()

Дебаевская длина
экранирования. Она показывает , на каком расстоянии происходит изменение n.

Рассмотрим
ту часть п.п. где n убывает => С2 → 0
x=0 ∆n = ∆n(0)

изменение n-
избыточных электронов с расстоянием
Видим физ. смысл ![]() на расстоянии
на расстоянии ![]() ∆n уменьшается в е раз по
сравнению с ∆n(0).
∆n уменьшается в е раз по
сравнению с ∆n(0).
Для п.п. ![]() 10-4 – 10-
10-4 – 10-

Физический смысл τM
–это время в течении которого ∆n уменьшается в е раз по
сравнению с ∆n0. Характерное τM для п.п. составляет 10-12с
20. Диффузия и дрейф неосновных избыточных носителей заряда.
Рассмотрим пп n типа.
Дырки начинают диффу ндировать в неосвещаемую область при этом происходит
диффузия нейтральных частиц. Суммарный ток через п/п равен 0.
Рассмотроим диф. дырок:


Вводят постоянные


L1, L2 -длина затягивания. Дырки
увлекают за собой в темную область. На этих расстояниях концентрация дырок
уменьшается в е раз. Если внешнее эл. поле равно нулю то Е=0


Если Е не равно 0, то L1>Lp Дырки ускоряются вправо
увлекая электроны.
L справа > L слева

Поле
считается слабым если
![]()
Тогда
L1,2 = Lp
Найдем критическое поле Ес из
условия

При Е < Ес поле
слабое, при Е > Ес – сильное.
Т.о. основные и не основные
носители оказывают различное влияние на работу п/п приборов. Не основные
носители ограничивают быстродействие многих п/п приборов т.к.τр>>
τM. При больших f не основные носители в базе
транзистора не успевают релаксировать. Существуют приборы, которые работают на
основных и которые работают на не основных носителях заряда.
21. П/п во внешнем электрическом поле.


К п/п прикладываем полож.
заряженную пластинку из метала. У поверхности п/п-ка будет возникать объемный
отриц. заряд.
За счет эл. поля в п/п-ке
![]()
![]()

Уровень ферми не
искривляется, при этом смещается в сторону дно Ес. Если в п/п F
находится глубоко, он не выйдет в Ес.
Если выйдет – то п/п станет
вырожденным.
Если поменяем полярность U, то


Изгиб – там, где есть эл.
поле. Если в глубине п/п F был ближе к Ес
(п/п n-типа), то вблизи границы F может стать ближе к Ev (п/п р-типа). ![]() слой, в котором свойства п/п-ка близки к свойствам
проводника собственной провод. (
слой, в котором свойства п/п-ка близки к свойствам
проводника собственной провод. (![]() физический p-n переход)
физический p-n переход)
Рассмотрим уравнение Пуассона

Концентрация электронов в
зоне проводимости
![]()

![]()
![]()

Рассм. случай слабого
искривления энергетических зон (малое поле) =>
![]()
kT при комнатной T
![]() эВ ;
эВ ; ![]()
![]() эВ
эВ

![]()


 ,
,
 –Дебаевская
длина экранирования
–Дебаевская
длина экранирования
С найдем из граничных условий
(на поверхности п/п)
![]() ,
, ![]()




Чем больше концентрация
электронов, тем на меньшее расстояние эл. поле проникает в глубь п/п. (для
металлов![]() – расстояние между узлами крист. решетки )
– расстояние между узлами крист. решетки )
22. Контакт метал-полупроводник. Омические контакты.

Е0 – уровень
вакуума (при такой Е электроны становятся свободными в следствии
термоэлектронной эмиссии)
Фм –
термодинамическая работа выхода из метала; Фп – термодинамическая
работа выхода из п/п.
χ – внешняя работа
выхода
I. В случае: Фм
> Фп
Приведем эти материалы в
контакт. Начнется обмен эл-ми. Т.к. F п/п выше F м =>
эл.
начнут переходить из п/п в м., стремясь занять положение с меньшей Е. Возникает
контактная разность потенциалов. Обмен зарядами прекр., когда контактное Е
уравновесит этот ток.

![]() – контактная разность потенциалов
– контактная разность потенциалов
Т.к. поле в метал не
проникает, то оно будет сосредоточено в п/п.
L0 –
толщина области объемного заряда.
![]()
Контакт м-м используется в
термопаре. При контакте п/п с металлом образуется запорный слой – слой с
высоким омическим сопротивлением.
II. В случае: Фм > Фп

Например эл. поле будет
противоположным. В равновесии энерг. зоны примут вид:

В обл. L0 n будет
повышено => сопр. будет меньше. Это антизапорный контактный слой (прим.: при изготовлении
низкоомных конденсаторов с п/п-ми). Аналогично можно рассмотреть контакт
полупроводника р-типа с металлом (искривление зон будет в другую сторону).
Рассчитаем L0 на основе ур. Пуассона (для
контакта мет-п/п)
![]()
![]()
Считаем, что ![]() . Тогда
. Тогда ![]()
![]()
Будем считать, что ![]() (вся донорная примись ионизирована).
(вся донорная примись ионизирована).

![]()
Используем начальные условия:
1. ![]()
2. 
3. ![]()
2. => ![]()
![]()
![]()
![]()

1. => ![]()
![]()
![]()
![]()
![]()
3. => ![]()

![]() –
разность потенциальных энергий.
–
разность потенциальных энергий.
Сравнивая с Дебаевская длиной
экрана 
Омический контакт
О.к. – такой контакт в
котором сопротивление
контактно мало и одинаково в
обоих направлениях. Часто он необходим при изготовлений контакта
м-полупроводник. Есть три способа достичь малого сопротивления.
1.Создать антизапорные слой в
полупроводник п-тип
![]()

2.Создать контакт с плоскими
зонами.
Подберем ![]() . Но такие материалы трудно подобрать.
. Но такие материалы трудно подобрать.

Кроме того, не существует
идеального проводника на его поверхности существует поверхностные электронные
состояния, и (возможен захват электронов) изгиб зон всегда есть. Достигают
очень малую толщину область обычного заряда. Это достигает сильным легированием
полупроводника.

Может наблюдение явление
тунелирование – прохождение электронов через переход без потери энергий.
Электроны туннелируют в одном или другом направление.

23. Выпрямление тока в контакте метал-полупровадник. Диоды Шоттки.
Приложим к контакту напряжение прямого смещения. При этом
потенциал барьера уменьшается.
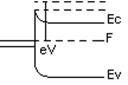
Через переход будет течь ток
![]()
По закону термоэлектронной
эмиссий
![]()
ге А- постоянная Ригорсона.

![]() и
и![]() -соответствующие роботы выхода.
-соответствующие роботы выхода.

Суммарная плотность тока

![]() -
ток насыщения.
-
ток насыщения.

![]()
Вах несемитрична ![]() выпрямление
тока.
выпрямление
тока.
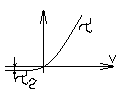
Это явление используется в
диодах Шоттки.
Диоды Шотки
Эти диоды созданы на основе
выправляемых свойств полупроводника.
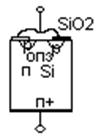 ОПЗ – область
пространственного заряда. Р – область необходимая для предотвращения
поверхностного пробоя. Основные носители заряда – электроны
ОПЗ – область
пространственного заряда. Р – область необходимая для предотвращения
поверхностного пробоя. Основные носители заряда – электроны ![]()
Диод может работать на
частоте ~10Ггц. В диодах та р-п –переходах![]() проблема
восстановления обратного V вследствие большого времени
жизни неосновных носителей. Недостаточно по с равнению с диодами на р-п –
переходах: малая мощность, сложность изготовления, малое прямое напряжение
(~0,1В).
проблема
восстановления обратного V вследствие большого времени
жизни неосновных носителей. Недостаточно по с равнению с диодами на р-п –
переходах: малая мощность, сложность изготовления, малое прямое напряжение
(~0,1В).
24. Емкость запорного слоя Шотки
Сопротивление области
контакта повышено в следствии обеднения => возникает барьерная емкость. По
формуле плоского конденсатора

На единицу площади:

![]()
При приложении к контакту
внешнего напряжения ее сб может возрастать или снижаться в
зависимости от того, приложено обратное или прямое U.

Это явление используется в
варикапах
![]()
Это уравнение прямой линии
![]()
В координатах ![]() ,
, ![]()
Как правило к контакту
прикладывают обратное U (иначе его сопротивление
падает).


Это вольт-фарадная
характеристика перехода.
25.Контакт електронного и дырочного полупроводников.
Считаем, что переход
идеальный, резкий. Будем считать, что примеси полностью ионизированные.
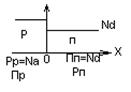
![]()
Происходит диффузия дырок
вправо и электричество в лево. На границе создаться объемный заряд. Возникнет
электрическое поле ![]() , который будет препятствовать диффузий основным
носителем.
, который будет препятствовать диффузий основным
носителем.
 При термодинамическом
равновесий возникнет контактная разность потенциалов.
При термодинамическом
равновесий возникнет контактная разность потенциалов.

Заряд ![]() в области
в области ![]()
Зонная энергия диаграммы р-п
– перехода
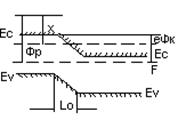
Изменение концентраций
носителей
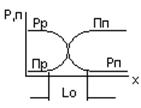
Для носителей потенциального
барьера нет.
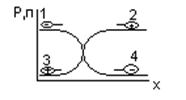
1,4 – плотности тока основных
носителей
2,3 – плотность тока
неосновных носителей
В равновесий тока основной и
неосновных носителей уравновешены.
![]()
![]()
Компонентная разность
потенциалов – разность термодинамической работы выхода.

![]() и
и![]() - уравнение Ферми в полупроводниках п и р – типа.
- уравнение Ферми в полупроводниках п и р – типа.
![]()
![]()

Используем формулу
![]()
![]()

Чем высшее степень
легирирования полупроводников, тем выше контактное разность потенциалов.

![]()
![]() концентрация
неосновных дырок
концентрация
неосновных дырок

 -
концентрация не основных электронов.
-
концентрация не основных электронов.
Найдем максимальную ![]() , которую можем достигнуть в р-п – переходе. Не
обходимо, чтобы в п полупроводнике F был близок к Ec, а в р полупроводнике близок к EV.
, которую можем достигнуть в р-п – переходе. Не
обходимо, чтобы в п полупроводнике F был близок к Ec, а в р полупроводнике близок к EV.
![]()
![]() для
кремния ~ 1В, для германия ~ 1В
для
кремния ~ 1В, для германия ~ 1В
26. Толщина слоя объемного заряда p-n перехода.
![]()
Уравнение Пуассона имеет вид:
![]() ,
,![]()
Для n-области:

![]()
Точка Х=0 соответствует
середине переходной области. В т Х=0 потенциалы должны:
![]()

Учитывая эти условия,
уравнения можно переписать по другому:

Это означает, что заряд слева
от р-п – перехода равен заряду справа (условия электронейтральности перехода )
![]()
![]()

![]()


Lo
зависит от ![]() , степени легирования. Крайнее случай:
, степени легирования. Крайнее случай:![]() и
и![]() Если приложено прямое V, то
Если приложено прямое V, то ![]() заменяем
заменяем ![]() , если обратно на
, если обратно на ![]() . В первом случай Lo стан. больше, во втором…
. В первом случай Lo стан. больше, во втором…
27. Выпрямление тока в р-n переходе.
Рассмотрим приложение
внешнего U к контакту. Как и в контакте метала с проводником
происходит выпрямление тока. Приложим U смещение. Все внешние
электрическое поле будет приложено к области объемного заряда, контакт являться
слоем повешенного сопротивления по средним глубинным сопротивлением
полупроводников. Потенциальный барьер стал ниже. Ток основных носителей стал
больше, чем ток не основных. Происходит индукция не основных носителей. В n –
бласти за щет инжекции: ![]()
![]() -
за счет внешнй U
-
за счет внешнй U
![]()

![]() Аналогично для избыточных электронов в р
области:
Аналогично для избыточных электронов в р
области:
![]()
ВАХ р-п -перехода

28. ВАХ ТОНКОГО ПЕРЕХОДА.
Толщина объемного заряда ![]()
![]()
![]() ;
; 
 ;
;
![]() ;
;
 ;
;
![]() ;
;![]()
![]()
![]() ;
;![]() ;
;
 ;
;
 ;
; ![]()

![]() ;
;
![]() ;
;
 ;
;  ;
;
 ;
;
![]()
![]()
![]()
![]()

 ;
;
Если вместо :

то

![]()


29. Барьерная и диффузионная емкости p-n-перехода
При подаче на p-n-переход
переменного напряжения проявляются емкостные свойства.Образование p-n-перехода
связано с возникновением пространственного заряда, создаваемого неподвижными
ионами атомов доноров и акцепторов. Приложенное к p-n-переходу внешнее
напряжение изменяет величину пространственного заряда в переходе.
Следовательно, p-n переход ведет себя как своеобразный плоский конденсатор,
обкладками которого служат области n- и p-типа вне перехода, а изолятором
является область пространственного заряда, обедненная носителями заряда и
имеющая большое сопротивление.Такая емкость p-n-перехода называется барьерной.
Барьерная емкость CБ может быть рассчитана по формуле ![]() где S - площадь p-n-перехода;
где S - площадь p-n-перехода;
![]() - относительная (
- относительная (![]() ) и абсолютная (
) и абсолютная (![]() ) диэлектрические
проницаемости;
) диэлектрические
проницаемости; ![]() - ширина
p-n-перехода.Особенностью барьерной емкости является ее зависимость от внешнего
приложенного напряжения. С учетом (2.2) барьерная емкость для резкого перехода
рассчитывается по формуле: ,
- ширина
p-n-перехода.Особенностью барьерной емкости является ее зависимость от внешнего
приложенного напряжения. С учетом (2.2) барьерная емкость для резкого перехода
рассчитывается по формуле: , где знак ” + “ соответствует
обратному , а ”-“ прямому напряжению на переходе.Зависимость барьерной емкости
от обратного напряжения называется вольтфарадной характеристикой
где знак ” + “ соответствует
обратному , а ”-“ прямому напряжению на переходе.Зависимость барьерной емкости
от обратного напряжения называется вольтфарадной характеристикой

(см. рис. 2.6). В зависимости
от площади перехода, концентрации легирующей примеси и обратного напряжения
барьерная емкость может принимать значения от единиц до сотен пикофарад.
Барьерная емкость проявляется при обратном напряжении; при прямом напряжении
она шунтируется малым сопротивлением rpn .Кроме барьерной емкости p-n-переход
обладает так называемой диффузионной емкостью. Диффузионная емкость связана с
процессами накопления и рассасывания неравновесного заряда в базе и
характеризует инерционность движения неравновесных зарядов в области
базы.Диффузионная емкость может быть рассчитана следующим образом: , где tn - время жизни
электронов в базе.Величина диффузионной емкости пропорциональна току через
p-n-переход. При прямом напряжении значение диффузионной емкости может
достигать десятков тысяч пикофарад. Суммарная емкость p-n-перехода определяется
суммой барьерной и диффузионной емкостей. При обратном напряжении CБ > CДИФ;
при прямом напряжении преобладает диффузионная емкость CДИФ >> CБ.
где tn - время жизни
электронов в базе.Величина диффузионной емкости пропорциональна току через
p-n-переход. При прямом напряжении значение диффузионной емкости может
достигать десятков тысяч пикофарад. Суммарная емкость p-n-перехода определяется
суммой барьерной и диффузионной емкостей. При обратном напряжении CБ > CДИФ;
при прямом напряжении преобладает диффузионная емкость CДИФ >> CБ. Рис.
2.7
Рис.
2.7
Эквивалентная схема
p-n-перехода на переменном токе представлена на рис. 2.7. На эквивалентной
схеме параллельно дифференциальному сопротивлению p-n-перехода rpn включены две
емкости CБ и CДИФ ; последовательно с rpn включено объемное сопротивление
базы rБ. С ростом частоты переменного напряжения, поданного на p-n-переход,
емкостные свойства проявляются все сильнее, rpn шунтируется емкостным
сопротивлением и общее сопротивление p-n-перехода определяется объемным
сопротивлением базы. Таким образом, на высоких частотах p-n-переход теряет свои
нелинейные свойства.
30. Контакт вырожденных электронного и
дырочного полупроводников.
В р-п переходе,
образованном двумя областями невырожденного электронного и дырочного
полупроводников, ток обусловливается прохождением электронов над потенциальным
барьером. В случае вырожденного полупроводника с концентрацией примесей в обеих
областях порядка 1018 —1020 см-3 переходный
слой будет очень тонкий и возможно прохождение электронов через р-п переход в результате туннельного
эффекта, а поэтому вид ВАХ будет принципиально отличаться от обычной диодной
характеристики. Благодаря возникновению туннельного эффекта наблюдается резкий
рост тока при обратной полярности напряжения (к р-области присоединен
отрицательный вывод источника), а на участке прямого смещения появляется
область отрицательного дифференциального сопротивления (рисунок).

Значительный туннельный ток возникает в
р-п переходах толщиной около 10 нм, когда при контактной разности
потенциалов около 1 В напряженность поля в переходе
приближается к 106 В/см. Такая толщина перехода для большинства
полупроводников наблюдается при концентрации примеси, лежащей в указанном выше
диапазоне.
Рассмотрим ход ВАХ туннельного диода на различных участках. Ниже приведена
упрощенная энергетическая диаграмма контакта вырожденных полупроводников при
отсутствии внешнего смещения.
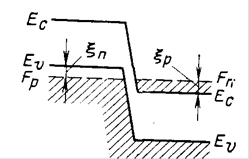
Штриховкой
показаны состояния, занятые электронами. Значения ![]() характеризуют степень вырождения
соответствующих областей полупроводника и определяют суммарное перекрытие
разрешенных энергетических зон. Благодаря наличию такого перекрытия электроны
могут переходить из одной области в другую за счет туннелирования сквозь
потенциальный барьер. Допустим, что теперь к р-п переходу приложено
обратное смещение. В этом случае, как следует из рисунка
характеризуют степень вырождения
соответствующих областей полупроводника и определяют суммарное перекрытие
разрешенных энергетических зон. Благодаря наличию такого перекрытия электроны
могут переходить из одной области в другую за счет туннелирования сквозь
потенциальный барьер. Допустим, что теперь к р-п переходу приложено
обратное смещение. В этом случае, как следует из рисунка
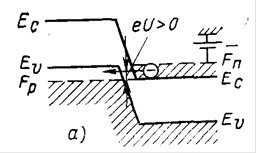
все энергии в
п-области снижаются относительно р-области и поток
электронов из р-области в п-область резко возрастает,
так как увеличивается количество заполненных уровней в полупроводнике р-типа,
против которых при той же энергии лежат свободные уровни в зоне проводимости
материала n-типа. Поток электронов в обратном направлении при этом уменьшится.
Суммарный ток электронов обозначен на рисунке стрелкой, этому режиму
соответствует точка 2 на ВАХ. Увеличение обратного напряжения
сопровождается ростом туннельного тока.
Рассмотрим диод
при прямом смещении.
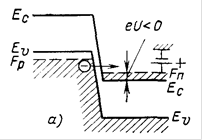
При небольших
положительных напряжениях возрастает количество электронов, туннелирующих из n-области в
р-область при одновременном снижении встречного потока. Описанному режиму
соответствует точка 3 на ВАХ.
При дальнейшем
повышении прямого напряжения, перекрытие разрешенных зон проходит через
максимум и начинает уменьшаться, что ведет за собой снижение туннельного тока.
При этом рабочая точка на ВАХ будет перемещаться к точке 4. Увеличение входного
напряжения до величины ![]() , когда
, когда ![]() , приведет к уменьшению туннельного тока до нуля.
, приведет к уменьшению туннельного тока до нуля.
Однако по мере
повышения прямого смещения на р-n переходе высота
потенциального барьера понижается и будет возрастать диффузионный ток основных
носителей заряда, способных преодолеть снижающийся потенциальный барьер. Ток
будет увеличиваться по тому же закону, что и в обычном диоде (точка 5 на ВАХ)
Благодаря наличию
участка отрицательного дифференциального сопротивления туннельный диод может
быть использован для усиления и геренации колебаний.
31. Фотоэффект на p-n-переходе
Рассмотрим контакт p-полупроводника и n-полупроводника (p-n-переход). В области контакта происходит изгиб энергетических зон,
приводящий к их взаимному смещению. Это показано на рис.1, где штриховой прямой
изображен уровень энергии Ферми (в состоянии термодинамического равновесия
положение уровня Ферми в p-области
совпадает с его положением в n-области),
1 — дно зоны проводимости, 2 — вершина валентной зоны. 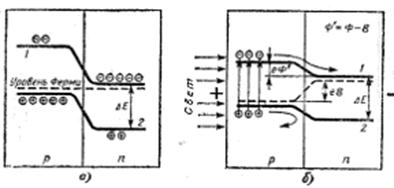
Рис.1
Основными носителями заряда в
p-области являются дырки; их
концентрация много больше концентрации электронов проводимости. В n-области наблюдается обратная
картина; там основными носителями являются электроны проводимости. Диффузии
электронов проводимости из области с высокой их концентрацией (n-области) в область с низкой
концентрацией (в p-область) препятствует
потенциальный барьер высотой еФ; Ф — контактная разность потенциалов.
Аналогичное замечание можно сделать относительно диффузии дырок из p-области в n-область. Иными словами,
контактная разность потенциалов в p-n-переходе препятствует уходу
основных носителей из «своей» области. В то же время она способствует уходу в
другую область неосновных носителей (но этому уходу препятствует более высокая
концентрация соответствующих носителей в той области, куда они могли бы уйти).
Предположим теперь, что на p-полупроводник с наружной
стороны падает поток фотонов (рис.1,б). Энергия фотонов превышает ширину
запрещенной зоны. Фотоны генерируют электроны проводимости и дырки, которые,
возникнув, начинают диффундировать через p-область по направлению к p-n-переходу. Электроны
проводимости являются для p-области
неосновными носителями, поэтому внутреннее поле в p-n-переходе «втягивает» их в n-область. Что же касается
дырок, то они являются для p-области
основными носителями, поэтому поле в p-n-переходе задержит их и
возвратит обратно в p-область.
В результате происходит пространственное разделение оптически генерированных
электронов и дырок; p-полупроводник
приобретает положительный, а n-полупроводник
— отрицательный заряд, что эквивалентно возникновению ЭДС. При этом уровни
Ферми в p-области и n-области смещаются друг
относительно друга на еe, где e — фотоЭДС; контактная разность потенциалов уменьшается на e (рис.).
Внутренний фотоэффект,
проявляющийся в возникновении фотоЭДС, называют также фотогальваническим (или фотовольтаическим)
эффектом. Одним из видов этого эффекта является возникновение вентильной (барьерной) фотоЭДС в p-n-переходе.
32. Гетеропереходы.
Полупроводниковый
гетеропереход(П. г.), контакт двух различных по химическому составу
полупроводников. На границе раздела изменяется обычно ширина запрещенной зоны,
подвижность носителей тока, их эффективные массы и др. характеристики
полупроводников. В «резком» П. г. изменение свойств происходит на расстоянии,
сравнимом или меньшем, чем ширина области объёмного заряда. В зависимости от
легирования обеих сторон П. г. можно создать р—n-гетеропереходы (анизотипные),
р—р- и n—n-гетеропереходы (изотипные). Комбинации различных П. г. и
р—n-переходов образуют гетероструктуры.
Идеальная
стыковка кристаллических решёток в П. г. возможна лишь при совпадении типа,
ориентации и периода кристаллических решёток сращиваемых материалов. Кроме
того, в идеальном П. г. граница раздела должна быть свободна от структурных и
др. дефектов (дислокаций, заряженных центров и т.п.) и механических напряжений.
Наиболее широко применяются монокристаллические П. г. между полупроводниковыми
соединениями типа AIIIBV и их твёрдыми растворами на
основе арсенидов, фосфидов и антимонидов Ga и Al. Благодаря близости
ковалентных радиусов Ga и Al изменение химического состава происходит без
изменения периода решётки. Изготовление монокристаллических П. г. и
гетероструктур стало возможным благодаря развитию методов эпитаксиального
наращивания полупроводниковых кристаллов.
П.
г. используются в различных полупроводниковых приборах: полупроводниковых
лазерах, светоизлучающих диодах, фотоэлементах, оптронах и т.д.
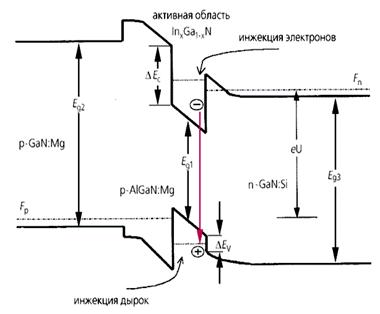
Энергетическая диаграмма p-n гетероструктуры типа InGaN/AlGaN/GaN при
прямом смещении U. Темными стрелками показана инжекция электронов и дырок в
активную область p-n гетероструктуры. Попадая в узкие и достаточно глубокие
ямы, электроны и дырки оказываются запертыми в них. Если активный слой (с узкой
запрещенной зоной Eg1) содержит малое количество дефектов,
электронно-дырочные пары рекомбинируют с излучением кванта Eg1
[светлая стрелка(-)→(+)].
Отказ
от легирования активной области принципиально важен, поскольку атомы примеси,
как уже говорилось, могут служить центрами безызлучательной рекомбинации. Попав
в яму, инжектированные электроны наталкиваются на потенциальный барьер DEc,
дырки - на барьер DEv, поэтому и те, и другие перестают диффундировать
дальше и рекомбинируют в тонком активном слое с испусканием фотонов.
33. Принцип действия Б.Т. Физические параметры Б.Т.
Схематическое изображение транзистора:
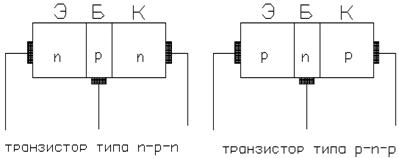
Рассмотрим принцип работы транзистора.
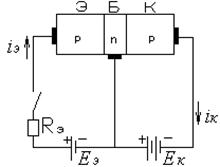 Когда ключ разомкнут, ток в
цепи эмиттера отсутствует. При этом в цепи коллектора имеется небольшой ток
называемый обратным током коллектора (Ik). Это ток очень маленький ,
так как при обратном смещении коллекторного перехода потенциальный барьер велик
и непреодолим для основных носителей заряда – дырок коллектора и электронов
базы. Замыкание ключа в цепи эмиттера приводит к появлению тока в этой цепи.
Ток проходит через эмиттерный переход, получил название эмиттерного тока (Iэ). Он
равен
Когда ключ разомкнут, ток в
цепи эмиттера отсутствует. При этом в цепи коллектора имеется небольшой ток
называемый обратным током коллектора (Ik). Это ток очень маленький ,
так как при обратном смещении коллекторного перехода потенциальный барьер велик
и непреодолим для основных носителей заряда – дырок коллектора и электронов
базы. Замыкание ключа в цепи эмиттера приводит к появлению тока в этой цепи.
Ток проходит через эмиттерный переход, получил название эмиттерного тока (Iэ). Он
равен ![]() , но почти весь ток через эмиттерный переход
обусловлен дырками. Эффективность оценивается коэффициентом инжекции γ.
, но почти весь ток через эмиттерный переход
обусловлен дырками. Эффективность оценивается коэффициентом инжекции γ.  . Инжектированные через эмиттерный переход дырки
проникают вглубь базы. Почти все дырки успевают пройти через тонкий слой базы и
достигнуть коллекторного перехода участвуют в создании тока коллектора. Ток,
как степень рекомбинации дырок с электронами в области базы мала, можно считать
. Инжектированные через эмиттерный переход дырки
проникают вглубь базы. Почти все дырки успевают пройти через тонкий слой базы и
достигнуть коллекторного перехода участвуют в создании тока коллектора. Ток,
как степень рекомбинации дырок с электронами в области базы мала, можно считать
![]() . То есть, дырки, которые все же рекомбинировали в
области с электронами участвую в создании тока базы IБ:
. То есть, дырки, которые все же рекомбинировали в
области с электронами участвую в создании тока базы IБ: ![]() . Одним из основным параметром транзистора является коэффициент передачи тока эмиттера,
который равен отношению приращения тока коллектора к приращению тока эмиттера
при неизменном напряжении на коллекторном переходе:
. Одним из основным параметром транзистора является коэффициент передачи тока эмиттера,
который равен отношению приращения тока коллектора к приращению тока эмиттера
при неизменном напряжении на коллекторном переходе:  . Для оценки влияния рекомбинации носителей заряда в
базе на усилительные свойства транзистора используется коэффициент переноса носителей заряда в базе, который показывает
какая часть инжектированных эмиттером дырок достигнет коллекторного перехода:
. Для оценки влияния рекомбинации носителей заряда в
базе на усилительные свойства транзистора используется коэффициент переноса носителей заряда в базе, который показывает
какая часть инжектированных эмиттером дырок достигнет коллекторного перехода:  . Транзистор представляет собой управляющий прибор,
так как величина его IК зависит от IЭ →
. Транзистор представляет собой управляющий прибор,
так как величина его IК зависит от IЭ → ![]()

![]()


![]()
W – ширина базы.
jЭ – эффективность эмиттера.

Β – коэффициент переноса
базы. Он показывает : 
 - эффективность коллектора;
- эффективность коллектора;
 - коэффициент передачи по току;
- коэффициент передачи по току;
![]()


34.Распределение
носителей в базе транзистора. Модуляция ширины базы.
Для того, чтобы точно найти распределение
инжектированных носителей по базе биполярного транзистора р(х), нужно решить
уравнение непрерывности с учетом дрейфовой и диффузионной компонент тока:
 (1.1)
(1.1)
Будем рассматривать только стационарный
случай, когда dp/dt = 0, и для простоты - экспоненциальный закон
распределения примеси по базе. Введем параметр η = W/2L0
- коэффициент неоднородности базы. Уравнение (1.1) перепишем, учитывая, что
электрическое поле E = (kT/q)·(1/L0).
С учетом этого уравнение непрерывности приобретает следующий вид:
 (1.2)
(1.2)
Граничные условия для этого уравнения имеют
следующий вид исходя из того, что заданы эмиттерный ток Jэр
= γJэ и коллекторное напряжение Uк:

Рассмотрим физический смысл коэффициента
неоднородности базы η.


Следовательно,
 (2.1)
(2.1)
Из соотношения (2.1) следует, что коэффициент
неоднородности базы η определяется логарифмом отношения концентрации
примеси на границах базы.
Оценим значение коэффициента неоднородности
η. Максимальное значение концентрации в базе может составлять ND(0)
= 1017 см-3. При более высоких концентрациях ND(0)
будет уменьшаться эффективность эмиттера γ. Минимальное значение
концентрации в базе ND(W) ограничивается или собственной
концентрацией свободных носителей, или значением концентрации неконтролируемой
примеси и составляет ND(W) = 1012 см-3. При
этих параметрах максимальное значение коэффициента неоднородности η будет
η = 5, реальные же значения η = 2÷4.
Распределения инжектированных дырок в базе
дрейфового транзистора:

Распределение концентрации рn(х) по
толщине базы, рассчитанное при разных значениях коэффициента неоднородности
η:

Модуляция ширины базы:
В соответствии с формулами ![]() где
где ![]() – ток
насыщения (
– ток
насыщения (![]() ), и формулой для тока связи в виде нормальной
), и формулой для тока связи в виде нормальной
![]() и
инверсной
и
инверсной ![]() составляющих:
составляющих: ![]() , ток связи перестает зависеть от обратных
напряжений при
, ток связи перестает зависеть от обратных
напряжений при ![]() . Однако реально такая зависимость существует,
так как при увеличении обратных напряжений ширина n-p- переходов увеличивается,
а ширина базы уменьшается. Зависимость ширины базы от величины обратного
напряжения на коллекторе называется эффектом модуляции ширины базы или эффектом
Эрли. (Аналогичный эффект в эмиттерном переходе интереса не представляет, так
как на эмиттерный переход не подают больших обратных напряжений). На рис 3.12
показаны два распределения n(x) электронов в базе при двух значениях обратного
напряжения на коллекторном переходе. Видно, что при
. Однако реально такая зависимость существует,
так как при увеличении обратных напряжений ширина n-p- переходов увеличивается,
а ширина базы уменьшается. Зависимость ширины базы от величины обратного
напряжения на коллекторе называется эффектом модуляции ширины базы или эффектом
Эрли. (Аналогичный эффект в эмиттерном переходе интереса не представляет, так
как на эмиттерный переход не подают больших обратных напряжений). На рис 3.12
показаны два распределения n(x) электронов в базе при двух значениях обратного
напряжения на коллекторном переходе. Видно, что при ![]() ширина
базы уменьшилась на величину
ширина
базы уменьшилась на величину ![]() . При этом увеличился градиент концентрации
электронов
. При этом увеличился градиент концентрации
электронов ![]() и,
следовательно, увеличился и ток связи, являющийся диффузионным. Как следует из
рис. 3.12, большему обратному напряжению
и,
следовательно, увеличился и ток связи, являющийся диффузионным. Как следует из
рис. 3.12, большему обратному напряжению ![]() соответствует больший ток связи
соответствует больший ток связи ![]() ,
следовательно, и большие токи
,
следовательно, и большие токи ![]() и
и ![]() . Однако данный эффект в сотни раз слабее, чем
влияние прямых напряжений на переходах, и часто не учитывается, или учитывается
приближенно. Для учета эффекта Эрли уточняют формулу тока насыщения
транзистора I0,
принимая:
. Однако данный эффект в сотни раз слабее, чем
влияние прямых напряжений на переходах, и часто не учитывается, или учитывается
приближенно. Для учета эффекта Эрли уточняют формулу тока насыщения
транзистора I0,
принимая: ![]() , где I0 – ток, определенный без
учета эффекта Эрли,
, где I0 – ток, определенный без
учета эффекта Эрли, ![]() -
напряжение Эрли - параметр транзистора, характеризующий величину эффекта Эрли.
Обычно
-
напряжение Эрли - параметр транзистора, характеризующий величину эффекта Эрли.
Обычно ![]() составляет десятки вольт и более.
составляет десятки вольт и более.
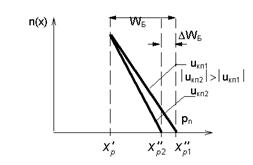
35. Полевые транзисторы с p-n переходом в качестве затвора. Схематическое
изображение ПТ с управляющим р - n переходом приведено на рисунке. Прибор состоит из области с проводимостью n- (или р-) типа, имеющей омические контакты,
называемые истоком и стоком, и двух областей р- (или n-) типа,
называемых затворами.
На (рис.а)
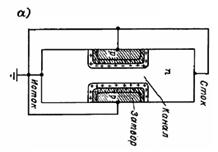 показан случай нулевого напряжения
на всех электродах. За счет наличия обедненных областей вблизи р- n-переходов толщина проводящего
канала между истоком и стоком меньше геометрического сечения n-области. Если к затворам приложить обратное смещение VDS, то размеры областей пространственного заряда
(ОПЗ) увеличиваются и толщина проводящего канала еще более уменьшается ( рис. б).
показан случай нулевого напряжения
на всех электродах. За счет наличия обедненных областей вблизи р- n-переходов толщина проводящего
канала между истоком и стоком меньше геометрического сечения n-области. Если к затворам приложить обратное смещение VDS, то размеры областей пространственного заряда
(ОПЗ) увеличиваются и толщина проводящего канала еще более уменьшается ( рис. б). 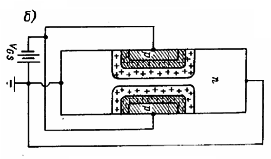
При приложении к стоку положительного по отношению
к истоку напряжения VDS по каналу течет ток ID
основных носителей (электронов), а толщина ОПЗ у стокового конца затвора
увеличивается вследствие возрастания обратного напряжения между затвором и
каналом (рис. в). 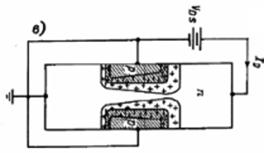
Таким образом, возрастание VDS приводит к увеличению сопротивления канала за счет уменьшения горловины
вблизи стока. При достаточно больших значениях VDS области пространственного заряда смыкаются (рис. г)
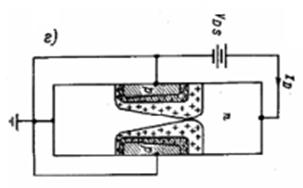
и дальнейшее увеличение VDS практически не вызывает возрастания тока (режим насыщения). Напряжение
между затвором и стоком, соответствующее смыканию ОПЗ, называется напряжением
насыщения Vp0.Следует отметить, что канал может быть полностью
перекрыт только при ID =0. При работе прибора в режиме насыщения вблизи
стока существует очень узкая проводящая область, в которой плотность тока и
электрическое поле велики. На стоковых характеристиках ПТУП (рис. 2,а) точки
пересечения штриховой линии с кривыми ID ( VDS / Vp0.) соответствуют началу режима насыщения. 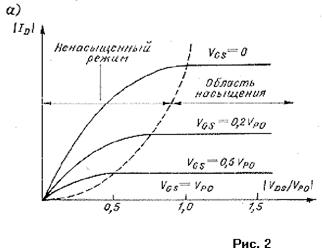
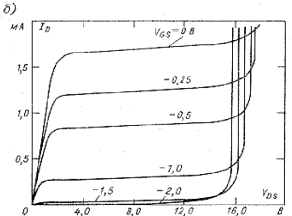
На практике при насыщении все же наблюдается
незначительное возрастание тока с ростом VDS (рис. 2,б). Это возрастание связано с распространением ОПЗ по направлению
к стоковому контакту и частично с увеличением электрического поля в канале. За
счет расширения области смыкания в сторону истока стока возрастает так, как
если бы длина затворов уменьшалась, а толщина канала оставалась постоянной. Это
явление, называемое эффектом укорочения канала, определяет конечную величину
сопротивления канала при увеличении VDS.Рассмотрим
влияние напряжения затвора на характеристики прибора. Пусть VDS | Vp0|, а VGS =0. Этот случай соответствует ненасыщенному режиму
работы (рис. 2,a). При увеличении обратного смещения на затворе толщина
канала уменьшается, ток стока падает, и при VGS = VDS + Vp0, где VGS ‹0 и Vp0‹0, наступает режим насыщения. Таким образом, с
ростом | VGS | значение VDS, соответствующее началу насыщения, уменьшается. С дальнейшим возрастанием
| VGS | ток стока становится равным нулю при VGS = Vp0. При этом канал полностью перекрыт и представляет
собой сплошную обедненную область.
36.
Эффект поля. МДП-транзисторы.
В
полевых транзисторах с изолированным затвором поперечное электрическое поле
прикладывается к металлическому электроду, отделенному от полупроводника слоем
диэлектрика. Рассмотрим энергетическую диаграмму структуры
металл-диэлектрик-полупроводник, сокращенно называемой МДП.
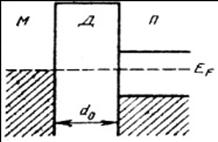
При
приложении внешнего напряжения
U3
такой полярности, что
металл заряжается положительно, на границе полупроводника с диэлектриком появляется индуцированный отрицательный заряд.
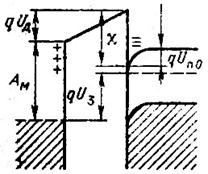
При смене полярности внешнего
напряжения в полупроводнике индуцируется положительный заряд, образуемый в результате
оттеснения электронов от поверхности в глубь полупроводника.

В зависимости от знака и
величины внешнего напряжения поверхностная проводимость может уменьшаться,
увеличиваться, а также менять знак носителей заряда. Изменение поверхностной проводимости
полупроводника, являющегося одной из
обкладок конденсатора, при изменении напряжения на нем называется «эффектом поля». Этот эффект используется
в полевых транзисторах с изолированным
затвором, называемых по типу структуры
МДП-транзисторами.
Существует два типа МДП-транзисторов, со встроенным
и инверсным каналами.
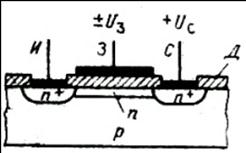
МДП-транзистор со встроенным каналом может работать при любой
полярности напряжения на затворе. При положительном напряжении область канала
обогащается электронами и его сопротивление
уменьшается, а при отрицательном – наоборот. Соответственно
меняется ток между истоком и стоком.
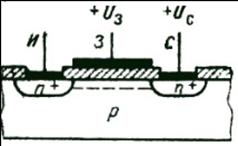
В конструкции МДП-транзистора с
инверсным каналом диффузионная область n-типа отсутствует. При отсутствии напряжения на затворе n контакты разъединены областью р-типа и ток между
ними не протекает. Если напряжение на затворе положительное, то концентрация
дырок у поверхности уменьшается и при достаточной величине U3 электронов у поверхности может стать больше, чем дырок, т. е. произойдет инверсия
типа электропроводности
полупроводника. Вследствие этого на поверхности образуется канал n-типа проводимости и между истоком и стоком протекает
ток. МДП-транзистор с индуцированным каналом работает только при одной полярности напряжения на затворе в отличие от транзистора со встроенным
каналом.

Выходные характеристики МДП-транзистора со
встроенным каналом n-типа
Подложка, на которой изготавливается
МДП-транзистор, имеет противоположный каналу тип проводности. При подаче на нее
обратного смещения она действует как затвор в полевом транзисторе с р-n-переходом. Изменяя постоянное напряжение на подложке, можно менять
начальную ширину капала, а следовательно, сдвигать
напряжение отсечки металлического
затвора
ФОРМУЛЫ
![]() понятие дрейфовой скорости
понятие дрейфовой скорости

![]()
![]() Закон Ома
Закон Ома


 - эффективная масса
- эффективная масса
 - ф-я Ф-Д
- ф-я Ф-Д
 – Эффективная плотность состояний в ЗП
– Эффективная плотность состояний в ЗП
![]()
![]() - концентрации
- концентрации
![]() - соотношение Эйнштейна
- соотношение Эйнштейна
![]()
 - для вырожденных п\п.
- для вырожденных п\п.
![]() - у-е ЭН в общ.
Виде.
- у-е ЭН в общ.
Виде.
Для п/п-ка n-типа
![]()
Для п\п-ка р-типа:
![]()
![]() - температурная зав-сть n при слабой ионизации п\п
- температурная зав-сть n при слабой ионизации п\п
 - температурная
зав-сть n при истощении
примеси п\п
- температурная
зав-сть n при истощении
примеси п\п
 температура истощения
температура истощения
 - уравнение Фурье для соб. n/п
- уравнение Фурье для соб. n/п
 - температура собств проводимости
- температура собств проводимости
 - температурная
зав-сть n при собственной
проводимости
- температурная
зав-сть n при собственной
проводимости
 – постоянная времени рекомбинации (время жизни
неравновесных носителей заряда в п/п-ке)
– постоянная времени рекомбинации (время жизни
неравновесных носителей заряда в п/п-ке)
 - мгновенное время жизни неравновесных
электронов при квадратичной рекомбинации.
- мгновенное время жизни неравновесных
электронов при квадратичной рекомбинации.
 - плотность тока
- плотность тока
 связь коэф диффузии с подвижностью
связь коэф диффузии с подвижностью
 изменение n- избыточных электронов с расстоянием
изменение n- избыточных электронов с расстоянием




 уравнение Пуассона
уравнение Пуассона
 –
Дебаевская длина экранирования
–
Дебаевская длина экранирования
 ширина объемного зарада п-н перехода
ширина объемного зарада п-н перехода
 барьерная емкость
барьерная емкость

 плотность тока в
контакте
плотность тока в
контакте
![]()
![]() -
уравнения Ферми в полупроводниках п и р – типа.
-
уравнения Ферми в полупроводниках п и р – типа.
 - высота потенц барьера
- высота потенц барьера
 - высота потенц барьера если примесь вся
ионизирована
- высота потенц барьера если примесь вся
ионизирована
![]() концентрация
неосновных дырок
концентрация
неосновных дырок
![]() - концентрация не
основных электронов.
- концентрация не
основных электронов.
![]() ВАХ п-н – перехода
ВАХ п-н – перехода